科研进展丨亚埃级等效氧化物厚度的高κ介质晶圆化集成取得重要突破
近日,由松山湖材料实验室/中国科学院物理研究所张广宇研究员、松山湖材料实验室李娜特聘研究员牵头,联合香港理工大学、香港城市大学、浙江钱塘高等研究院、剑桥大学以及马克斯·普朗克研究所等国内外顶尖科研机构,在超大规模集成电路栅介质研究领域取得里程碑式进展 。研究团队在国际权威学术期刊《自然-通讯》(Nature Communications)上发表了题为“Wafer-scale high-κ HfO2 dielectric films with sub-5-Å equivalent oxide thickness for 2D MoS2 transistors”的科研成果。该工作成功开发了一种工业兼容的多重氧化原子层沉积(MOALD)工艺,在8英寸晶圆尺度上实现了物理厚度仅为 1.3 nm、等效氧化物厚度(EOT)低至 2.5 Å 的超薄高κ氧化铪(HfO2)薄膜,突破了行业内对亚 5 Å EOT 介质层难以兼顾高性能与工业兼容性的长期挑战。
在半导体技术向亚埃技术节点(Angstrom Era)迈进的过程中,栅介质层的持续缩减是提升晶体管栅极掌控力和降低功耗的核心。然而,传统工艺在实现极薄介质时,往往面临氧空位浓度高、漏电流大以及击穿电场强度弱等瓶颈。针对此难题,研究团队创新性地采用 MOALD 工艺,通过在 200 ℃ 的较低温度下交替使用臭氧和氧等离子体进行氧化,极大地降低了HfO2薄膜内的氧空位缺陷。实验测试表明,这种新型 1.3 nm 厚的 HfO2介质不仅拥有高达 19.8 的介电常数,且在实现 2.5 Å 极低 EOT 的同时,保持了约 10-6 A/cm² 的超小漏电流以及高达 ~22.3 MV/cm 的鲁棒击穿电场,其综合电学性能达到了国际领先水平。
为了进一步验证该介质层在未来电子器件中的实用价值,研究团队在8英寸晶圆尺度上大规模集成了二维二硫化钼(MoS2)场效应晶体管及多种逻辑电路。基于 2.5 Å EOT 介质的MoS2 晶体管表现出优异的栅控特性:在 0.5 V 的漏源电压下,开启电流密度达到 260 µA/µm,开关比高达 108,平均亚阈值摆幅(SS)低至 75 mV/dec。此外,团队还成功演示了具备正确逻辑功能的反相器、与门(AND)、与非门(NAND)、或非门(NOR)以及五阶环形振荡器等电路单元。其中,反相器在 1V 电压下增益高达 205,静态功耗极低,充分展示了该技术在超低功耗逻辑运算领域的潜力。
该研究成果不仅实现了目前报道中最低的 EOT 值之一,且其工艺完全兼容标准的半导体制造流程,能够直接应用于现有的硅基 CMOS 及新兴的二维半导体技术中。这一突破性进展为国际器件与系统路线图(IRDS)提出的 2037 年远景目标提供了切实的技术方案,标志着我国在下一代先进集成电路关键材料与器件研究方面走在了国际前沿。
松山湖材料实验室/香港理工大学联培博士张颂歌为该论文第一作者,松山湖材料实验室/中国科学院物理研究所张广宇研究员、松山湖材料实验室李娜特聘研究员、浙江钱塘高等研究院冼乐德副教授为该论文共同通讯作者。
该研究得到了国家重点研发计划、国家自然科学基金以及广东省基础与应用基础研究重大项目等的大力支持。

图1 2.5Å等效氧化层厚度(EOT) HfO2薄膜的多重氧化原子层沉积(MOALD)
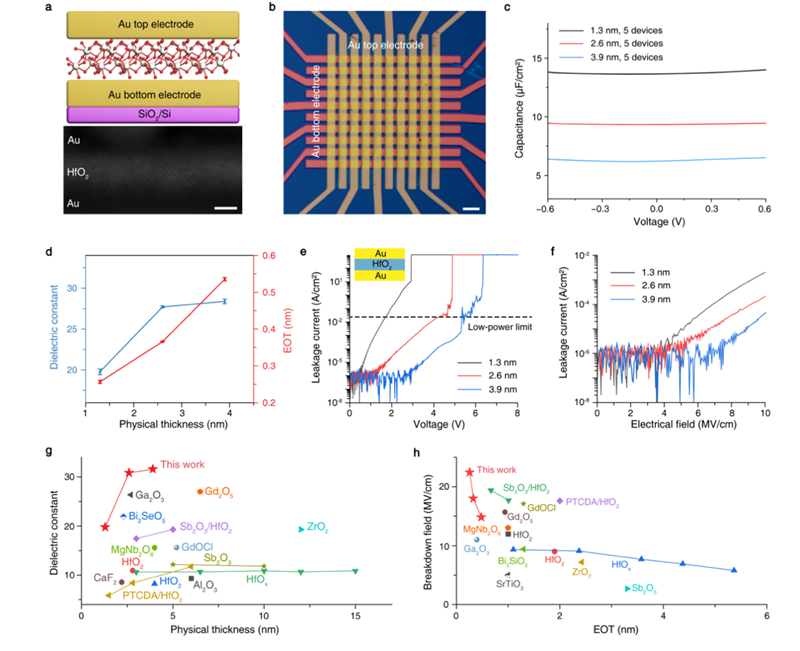
图2 超薄MOALD HfO2介电层的介电特性

图3 采用2.5Å等效氧化层厚度(EOT)HfO2介电层的MoS2场效应晶体管(FET)电学性能

图4 基于2.5Å等效氧化层厚度(EOT)的8英寸晶圆级MoS2场效应晶体管及集成电路
原文链接:https://www.nature.com/articles/s41467-026-68584-0
